高性能なチップは、いまや「チップの性能だけでは高性能を発揮できない」という存在になっています。演算性能が上がるほど発熱は増え、しかもパッケージが大型化すると、今度は基板との接続をどう安定して保つかという機械的な問題まで顕在化してきます。つまり、先端SoCの実装では、熱設計と構造設計を最適化する必要があるのです。
今回取り上げる Apple の特許 US12046534B2 は、この熱設計と構造設計に関する発明です。
特許の要点は、集積回路を基板にしっかり接続したまま、上下から熱を逃がす構造にあります。単なるヒートシンクの工夫ではなく、IC・ソケット・基板・放熱部材・プレート・ばね機構を一体のシステムとして設計している点が、この特許の特徴です。
従来、発熱対策は「チップの上から冷やす」という発想が通常でした。しかし、処理性能向上に伴って発熱が増えることに加え、ICサイズの拡大や接点数増加によって、ソケットとの電気的・機械的接続維持が難しくなることが問題にとなります。
この特許では、放熱と接触信頼性を同時に最適化し、高性能なチップのパフォーマンスを引き出す実装アーキテクチャが示されています。
この記事では、Appleの実用的な実装技術を「US12046534B2」の内容からわかりやすく解説します。
(この記事にない図面は、US12046534B2 からご参照ください。)
発明の概要
この特許の要点をひと言でいえば、集積回路と基板を上下から挟み込む構造体を用い、その両側に熱を引き抜く経路を設けることで、高発熱・大型化したICでも安定して動作させるというものです。
ベイパーチャンバー、フィンスタック、ヒートパイプなど複数の熱部材を組み合わせ、基板とその上のICに対して両面から熱抽出を行う仕組みになっています。
さらに、複数のプレートが発生する圧縮力が、ICのコンタクトパッドとICソケットのピンあるいはスプリングとの接触を維持します。
これにより、①高速動作によって増加した熱をICだけでなく基板上の他部品からも効率よく逃がし、②大型化したICと多数の接点をもつソケットの間で、反りや曲げモーメントが加わっても、接触を失わないという効果があります。
熱設計と機械設計が別々ではなく、一つの機構によって効果が発揮されることがこの特許の核心です。
発明のポイント
放熱機構と支持機構

Fig.2 は、この特許の基本構成の図です。この図で、上側の熱構造と圧縮支持のための主要部品が一望できます。図中の熱構成要素(110a) はフィンスタック、熱構成要素(110b)はベイパーチャンバーに相当し、その間を複数のパイプ(112a〜112e)が接続しています。これらのパイプはヒートパイプとして機能し、110b が受け取った熱を 110a 側へ運びます。さらに、その間に配置されるプレート(114a)は単なる中間板ではなく、熱部材の支持と圧縮力伝達の両方を担う重要部材です。プレート(114a)には開口が設けられ、パイプ(112a〜112e)がそこを貫通してフィンスタック側へ伸びる構成になっています。
この図では四隅に配置されたモジュール(120a〜120d)に注目です。拡大図で示されるように、モジュール(120a)にはホルダ(122a)とバイアス部品(124a)が含まれています。ホルダはナットとして、バイアス部品はバネとして働き、Fig.3 で説明する「締め具」と組み合わせて、均一な圧縮力を生み出します。つまり Fig.2 は、冷却部品の図であると同時に、接触信頼性を支える構造部品の図でもあるのです。
(正確な図面は、US12046534B2 をご参照ください。)
IC・基板・ソケットを含めた全体アセンブリ
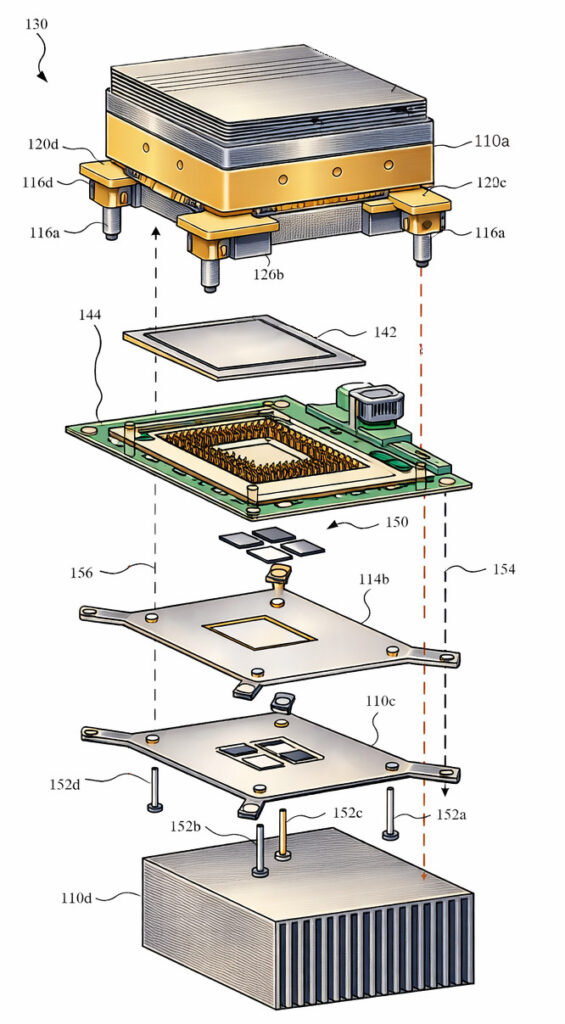
Fig.3 は、Fig.2 のサブアセンブリが、実際のIC実装構造にどう組み込まれるか示された図です。ここで中心になるのは IC(142)、回路基板(144)、ICソケット(146)です。IC(142)は SoC を想定し、ICソケット(146)は多数のピンまたはばねを持つ LGA ソケットとして記述されています。IC 側の表面(148)には複数の接触パッドがあり、それが ICソケット(146)の接点と噛み合うことで、IC と基板の電気接続が成立します。高性能化に伴って接点数が増えると、この接触を均一に保つことが難しくなりますが、この構造によって安定した電気接続となっています。
基板の反対面には電圧レギュレータ(150)が搭載されており、電源系からの発熱も無視できません。そのため下側にはプレート(114b)と熱部品(110c)、さらに熱部品(110d)が配置され、基板の裏面側からも熱を吸い上げて外へ逃がす構造となっています。上側だけでなく下側にもベイパーチャンバーやフィンスタック相当の経路を置くことで、基板全体を熱の通り道として活用しているわけです。
さらに Fig.3 では、ポスト(116a〜116d)が基板や下側部材を位置決めし、締め具(152a〜152d)が基板、ICソケット、プレート(114b)、熱部品(110c)を貫通して上側のモジュール(120a〜120d)に結合されることが示されています。
(正確な図面は、US12046534B2 をご参照ください。)
構成の断面図
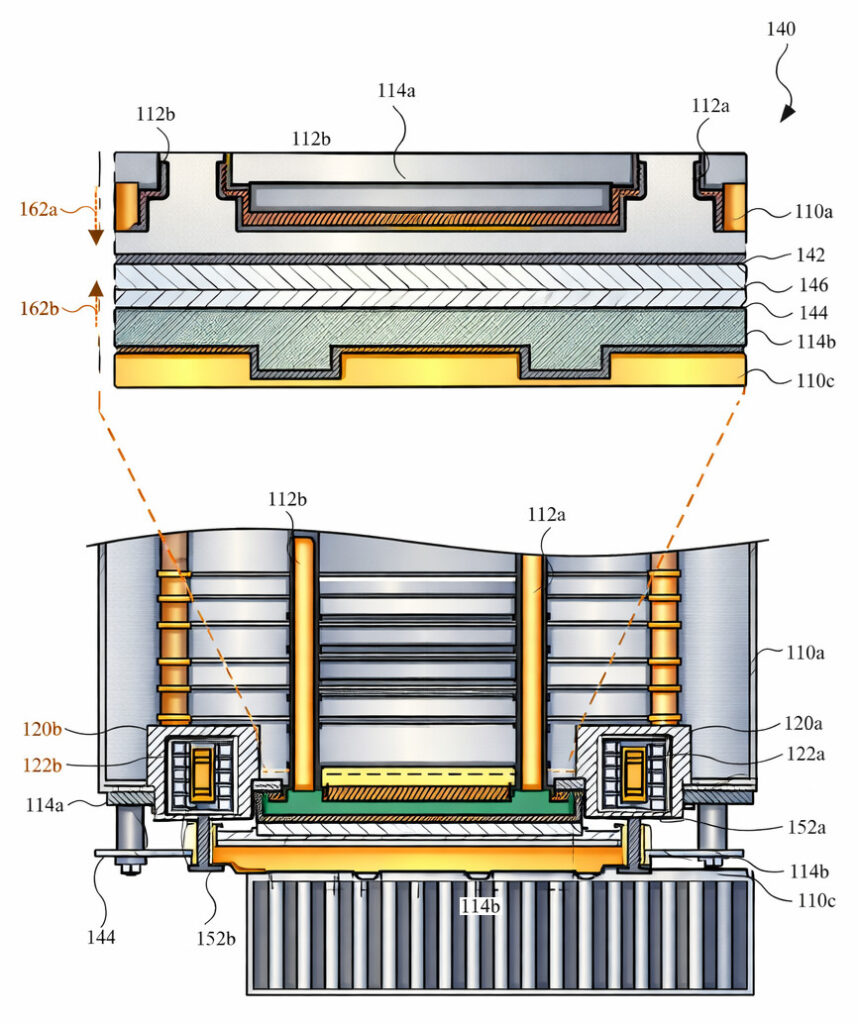
Fig.4 は、締め具とホルダーの締結によって バイアス部品(124a, 124b)が圧縮され、その反発力がプレート(114a)を介して上からIC(142)へ伝わる様子が示されています。図中の矢印162a は、ばね機構からIC(142)側へ向かう主たる力の方向です。一方で 締め具(152a, 152b)はプレート(114b)側にも力を与え、図中の矢印162b が示すように、下から基板へ向かう力を生みます。上下の力が互いに向き合うことで、IC と基板、より正確には IC(142)の接触パッドとICソケット(146)のピンとの接触が保たれる仕組みです。さらに、圧縮力を強くかけるだけではなく、プレート(114a)とプレート(114b)を高剛性材料で構成し、曲げや反りを抑える構造になっています。たとえばスチールプレートのような高い弾性係数を持つ材料を用いることで、外力が加わっても平面性を保ち、面全体に均一な圧力を与えるようになっています。大面積のSoCでは、わずかな反りでも接触不良や局所応力の原因になりますので、圧縮力を平坦に分配することが重要になります。
さらに Fig.4 では熱の流れも同時に説明されます。熱部品(110b)はIC(142)から熱を受け取り、パイプ(112a, 112b)などを通じて熱部品(110a)へ運びます。一方で熱部品(110c)は基板(144)や、Fig.3 で示された電圧レギュレータ(150)から熱を受け取り、熱部品(110d)に伝えます。つまり、上面はIC中心、下面は基板・電源系中心に冷やしつつ、両側から全体の熱だまりを崩していく構造です。従来の単一ヒートスプレッダよりも、熱設計の自由度がかなり高いと考えられます。
(正確な図面は、US12046534B2 をご参照ください。)
他の図面の説明
(図面は、US12046534B2 をご参照ください。)
Fig.1: 発明が適用される電子機器の外観
デバイス(100)はデスクトップ機器の例として描かれ、筐体(102)、I/Oポート(106a、106b、108 )などが示されています。
Fig.6:ICを支持する方法を示すフローチャート
ステップ502 で回路基板を第1プレートと第2プレートの間に配置し、ステップ504 で第1プレートへ外力を与え、ステップ506 で第2プレートへ外力を与えることで、ICと基板の電気的・機械的結合を維します。
Fig.7:電子デバイスのブロック図です。
構成要素として、プロセッサー(602)、ディスプレイ(610)、ストレージデバイス(640)、RAM(620)、ROM(622)などが示されています。
まとめ
- この特許の要点は、ICを上下から支える圧縮構造と、ICおよび基板の両面から熱を逃がす放熱構造を一体化した点にあります。
- 高性能SoC時代において問題になる、発熱の増大と接触信頼性の低下を同時に解こうとする、実践的な発明です。
最後までお読みいただきありがとうございました。
特許情報
特許番号:US 12,046,534 B2
タイトル:Structural And Thermal Management Of An Integrated Circuit
発明者:Simon J. Trivett, Brett W. Degner, Mahesh S. Hardikar, Michael E. Leclerc, Eric R. Prather, Kevin J. Ryan
出願人:Apple Inc.
出願日:2022/5/4
公開日:2024/6/23
特許の詳細については US12046534B2 を参照してください。
※企業の特許は、製品になるものも、ならないものも、どちらも出願されます。今回紹介した特許が製品になるかどうか現時点では不明です。ご注意ください。



